中科院:光刻技術得到重大發展
訊石光通訊網 發布時間:2021/6/11 15:44:44 編者:iccsz
摘要:6月10日,中國科學院官網刊文稱,上海光機所在計算光刻技術研究方面取得重要進展。
ICC訊 6月10日,中國科學院官網刊文稱,上海光機所在計算光刻技術研究方面取得重要進展。
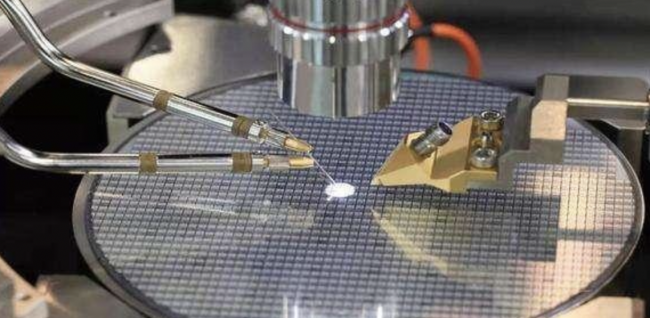
中科院上海光學精密機械研究所信息光學與光電技術實驗室,提出一種基于虛擬邊(Virtual Edge)與雙采樣率像素化掩模圖形(Mask pixelation with two-phase sampling)的快速光學鄰近效應修正技術(Optical proximity correction, OPC)。仿真結果顯示,這技術具有較高的修正效率。
隨著集成電路圖形的特征尺寸不斷減小,光刻系統的衍射受限屬性導致明顯的光學鄰近效應,降低了光刻成像質量。
在光刻機軟硬件不變的情況下,采用數學模型和軟件算法對照明模式、掩模圖形與工藝參數等進行優化,可有效提高光刻分辨率、增大工藝窗口,此類技術即計算光刻技術(Computational Lithography),被認為是推動集成電路芯片按照摩爾定律繼續發展的新動力。
快速光學鄰近效應修正技術(Optical proximity correction, OPC)通過調整掩模圖形的透過率分布修正光學鄰近效應,從而提高成像質量。基于模型的OPC技術是實現90nm及以下技術節點集成電路制造的關鍵計算光刻技術之一。
內容來自:集微網
本文地址:http://www.welmoon.com//Site/CN/News/2021/06/11/20210611074606436317.htm 轉載請保留文章出處
關鍵字: 光刻 中科院
文章標題:中科院:光刻技術得到重大發展
本文地址:http://www.welmoon.com//Site/CN/News/2021/06/11/20210611074606436317.htm 轉載請保留文章出處
關鍵字: 光刻 中科院
文章標題:中科院:光刻技術得到重大發展
【加入收藏夾】 【推薦給好友】
1、凡本網注明“來源:訊石光通訊網”及標有原創的所有作品,版權均屬于訊石光通訊網。未經允許禁止轉載、摘編及鏡像,違者必究。對于經過授權可以轉載我方內容的單位,也必須保持轉載文章、圖像、音視頻的完整性,并完整標注作者信息和本站來源。
2、免責聲明,凡本網注明“來源:XXX(非訊石光通訊網)”的作品,均為轉載自其它媒體,轉載目的在于傳遞更多信息,并不代表本網贊同其觀點和對其真實性負責。因可能存在第三方轉載無法確定原網地址,若作品內容、版權爭議和其它問題,請聯系本網,將第一時間刪除。
聯系方式:訊石光通訊網新聞中心 電話:0755-82960080-168 Right
2、免責聲明,凡本網注明“來源:XXX(非訊石光通訊網)”的作品,均為轉載自其它媒體,轉載目的在于傳遞更多信息,并不代表本網贊同其觀點和對其真實性負責。因可能存在第三方轉載無法確定原網地址,若作品內容、版權爭議和其它問題,請聯系本網,將第一時間刪除。
聯系方式:訊石光通訊網新聞中心 電話:0755-82960080-168 Right
- 設置首頁 | 光通訊招聘 | 企業搜索庫 | 廣告服務 | 聯系我們 | 保護私隱 | 公司介紹
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 訊石公司 www.welmoon.com版權所有 粵ICP備12008183號-1
